
Difference: Tutorial7thTCADDay4 (2 vs. 3)
Revision 32020-06-01 - AtlasjSilicon
4日目 (放射線耐性のシミュレーション)今日使うサンプルの準備今日使うサンプルをコピーしましょう。 | |||||||||
| Added: | |||||||||
| > > | |||||||||
cd ~/work/Silicon/TCAD/Sentaurus/tutorialsここでワークベンチを立ち上げ、Simple2Dirrad.tar.gzと言うファイルを読み込みます。 | |||||||||
| Added: | |||||||||
| > > | |||||||||
~/work/Silicon/TCAD/Sentaurus/tutorials/という場所にプロジェクトを保存してください。 早速sdeを走らせてみてください。 node8です。 安定したシミュレーションのため今回はpstopのexampleです。(Simple2D _dvs.cm をみて2日目の演習課題の答え合わせをしてみてください。) ガードリングも少し離してあります。 
TCAD 表面損傷のシミュレーション表面損傷のシミュレーション概要講義参照表面損傷のシミュレーション実習まずはノード n46-n50およびn136-n140を走らせてみてください。時間がかかりますので解説をします。 基本的な情報はmanual/sdevice_ug.pdf/chapter17にあります. bulk damageやsurface damageについて書いてありますが,ここでは表面電荷の置き方について. 電荷を置くには,デバイスシミュレーションの .cmdファイルに下のようなPhysicsの項目を足します. | |||||||||
| Added: | |||||||||
| > > | |||||||||
Physics (MaterialInterface= "Silicon/Oxide" ) {
# surface charge concentration in unit of cm^-2
# Traps (FixedCharge Conc=1e12)
Traps (FixedCharge Conc=@<0.8e12+0.3e12*log10(0.0021544347+TID)>@)
}
FixedChargeを Concentration [cm^-2]の量として指定します。
一般的には大体 1e12 cm^-2 程度の電荷がたまりますが、総電離損傷の大きさに依存します。
ここでは、TID(単位 Mrad)での電荷量を最初の講義で見た実データを用いた値に指定しています。
それではノード n46-n50のジョブが終わっていたらそれぞれのIVカーブをプロットしてみてください。
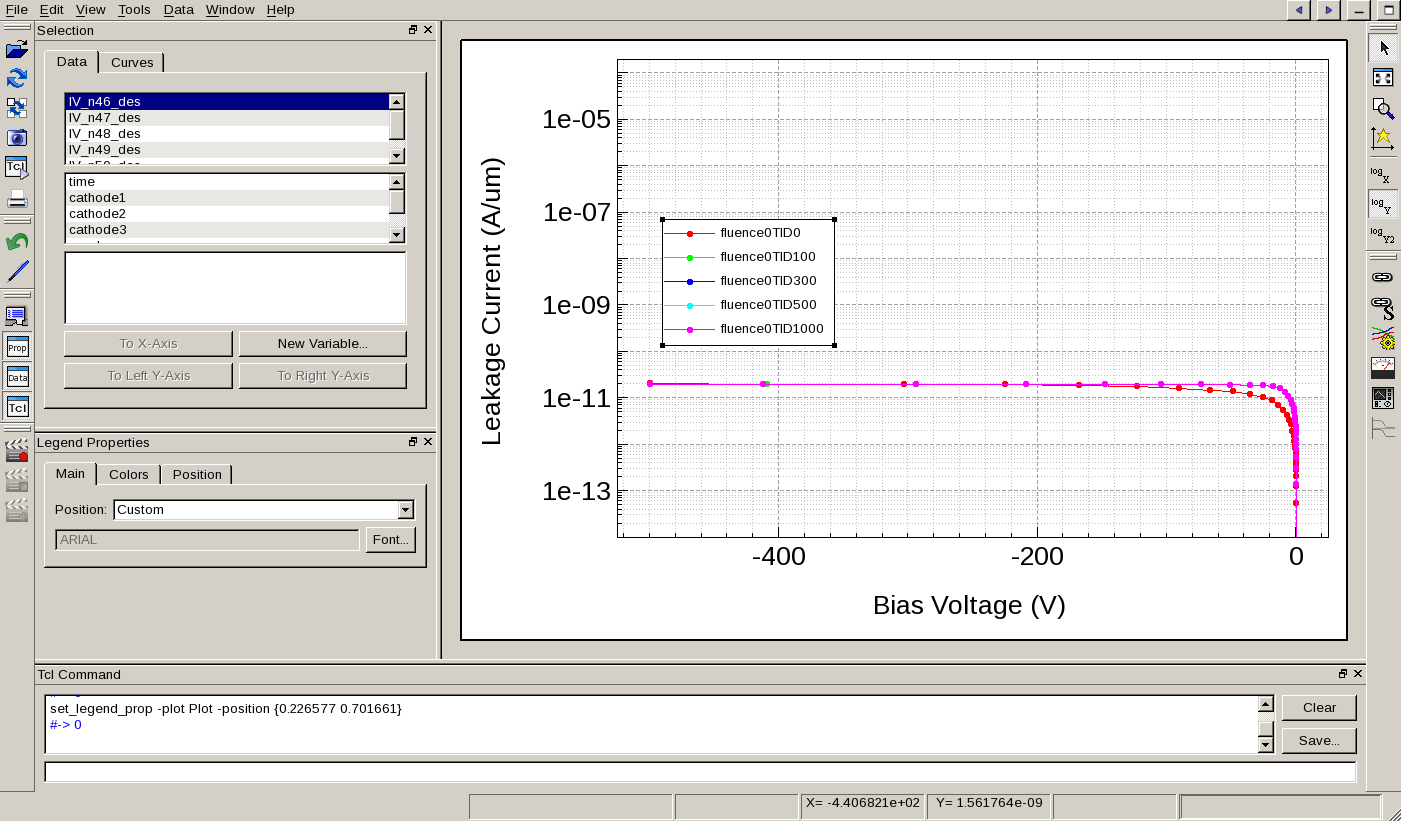 ちなみに、pspray を p-stopにしたことでBreakDownが起こらなくなりました。(ガードリングの端での電場の集中はp-sprayが原因だったようです。)
TID 100-1000 Mrad までのすべてのプロットは重なっていて見えません。(Curvesタブのcurveをひとつづつクリックするとわかります。)
電荷がたまってもほとんど電流電圧特性はほとんど影響を受けないことがわかります。
n136-n140のジョブが終わっていたらCVカーブ(1/c^2)をプロットしてみてください。
TID 100-1000までのプロットはすべて重なっています。
TID0に関しては前回同様いびつな形をしていますが、一度酸化膜に電荷を置くと並行板コンデンサに近くなるようです。
(全空乏化するまで 1/C^2が電圧に比例し、全空乏化すると一定になります)
このプロットから全空乏化電圧は 15V程度であることがわかります。
ちなみに、pspray を p-stopにしたことでBreakDownが起こらなくなりました。(ガードリングの端での電場の集中はp-sprayが原因だったようです。)
TID 100-1000 Mrad までのすべてのプロットは重なっていて見えません。(Curvesタブのcurveをひとつづつクリックするとわかります。)
電荷がたまってもほとんど電流電圧特性はほとんど影響を受けないことがわかります。
n136-n140のジョブが終わっていたらCVカーブ(1/c^2)をプロットしてみてください。
TID 100-1000までのプロットはすべて重なっています。
TID0に関しては前回同様いびつな形をしていますが、一度酸化膜に電荷を置くと並行板コンデンサに近くなるようです。
(全空乏化するまで 1/C^2が電圧に比例し、全空乏化すると一定になります)
このプロットから全空乏化電圧は 15V程度であることがわかります。
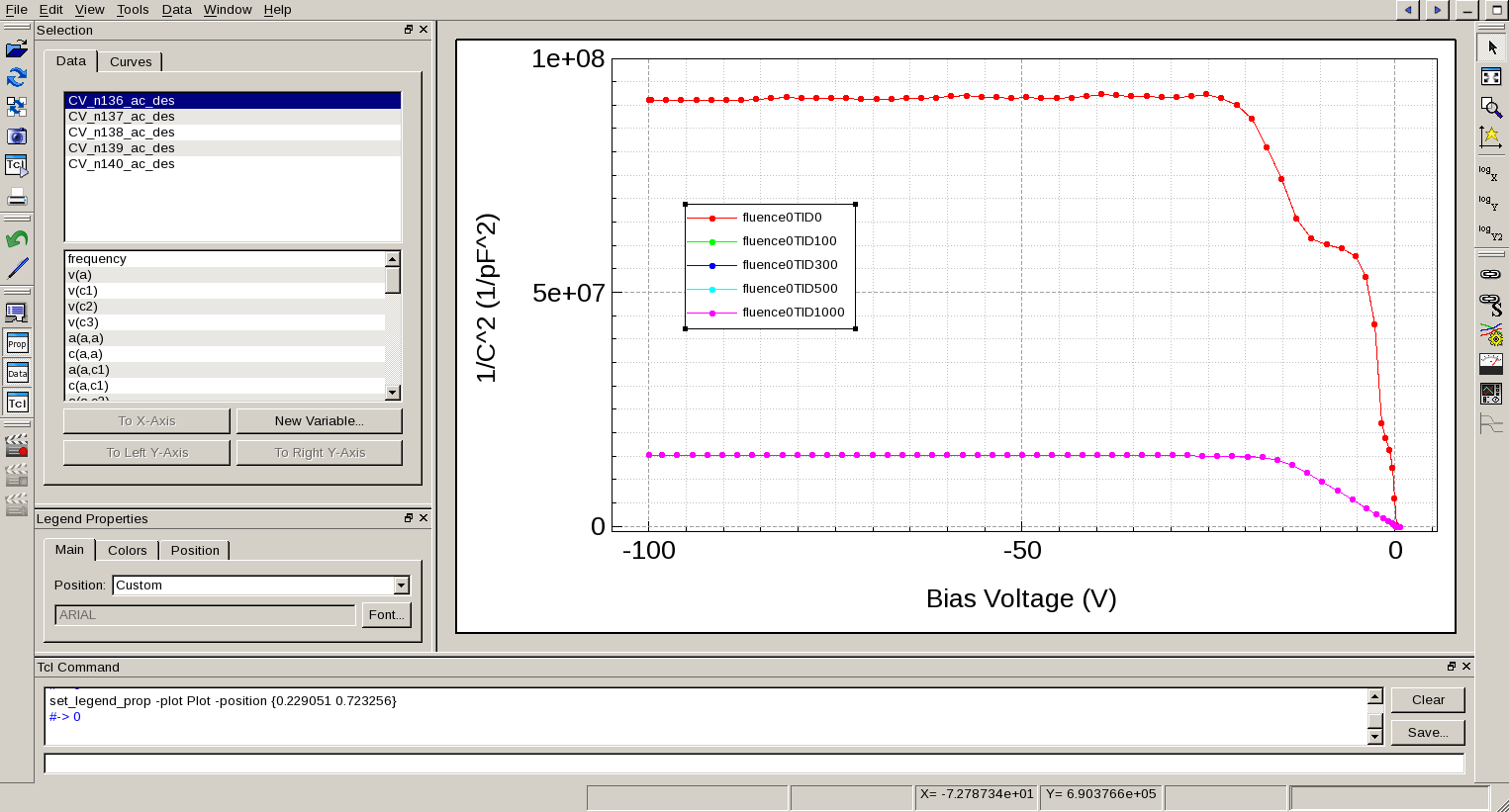
TCAD バルク損傷のシミュレーションバルク損傷のシミュレーション概要講義参照バルク損傷のシミュレーション実習同様のPixel2DIrradSimのプロジェクトを用いて行います。 TID=0 のノードでfluenceが違うIVとCVのデバイスシミュレーションを走らせてみてください。 IV: n46, n51, n56, n61, n66, n71 | |||||||||
| Changed: | |||||||||
| < < | CV: n137,n142,n147, n152, n157, n162 (TID100Mradの場合) | ||||||||
| > > | CV: n137,n142,n147, n152, n157, n162 (TID100Mrad の場合) | ||||||||
| Ctrlキーを押しながらクリックすると複数のノードがクリックできます。 それでは走っている間に解説です。基本的にはバルク部のTrapping が実装されていることだけです。 | |||||||||
| Deleted: | |||||||||
| < < | |||||||||
## defect density = fluence x eta
## state 1: acceptor, E = Ec-0.42 eV, sigma_e = 2e-15 cm2, sigma_h=2e-14 cm2, eta = 1.613 cm-1
## state 2: acceptor, E = Ec-0.46 eV, sigma_e = 5e-15 cm2, sigma_h=5e-14 cm2, eta = 100 cm-1
## state 3: donor, E = Ev+0.36 eV, sigma_e = 2.5e-14 cm2, sigma_h =2.5e-15 cm2, eta = 0.9 cm-1
Traps(
(
name="state1" acceptor conc=@<fluence*1.613>@
Level FromConductionBand EnergyMid=0.42
eXsection=2E-15 hXsection=2E-14
##eJfactor=1.0 hJfactor=1.0
)
(
name="state2" acceptor conc=@<fluence*100.0>@
Level FromConductionBand EnergyMid=0.46
eXsection=5E-15 hXsection=5E-14
##eJfactor=1.0 hJfactor=1.0
)
(
name="state3" donor conc=@<fluence*0.9>@
Level FromValenceBand EnergyMid=0.36
eXsection=2.5E-14 hXsection=2.5E-15
##eJfactor=1.0 hJfactor=1.0
)
)
IV/CV/MIPなどのSDEVICEにそれぞれTrap{}関数が含まれています。
IV simulationNon-irrad, 1e12 , 1e13, 1e14, 1e15, 1e16, 1e17 neq/cm2の照射量でIVカーブをシミュレーション IV: n46, n51, n56, n61, n66, n71 を走らせた後プロットを見る。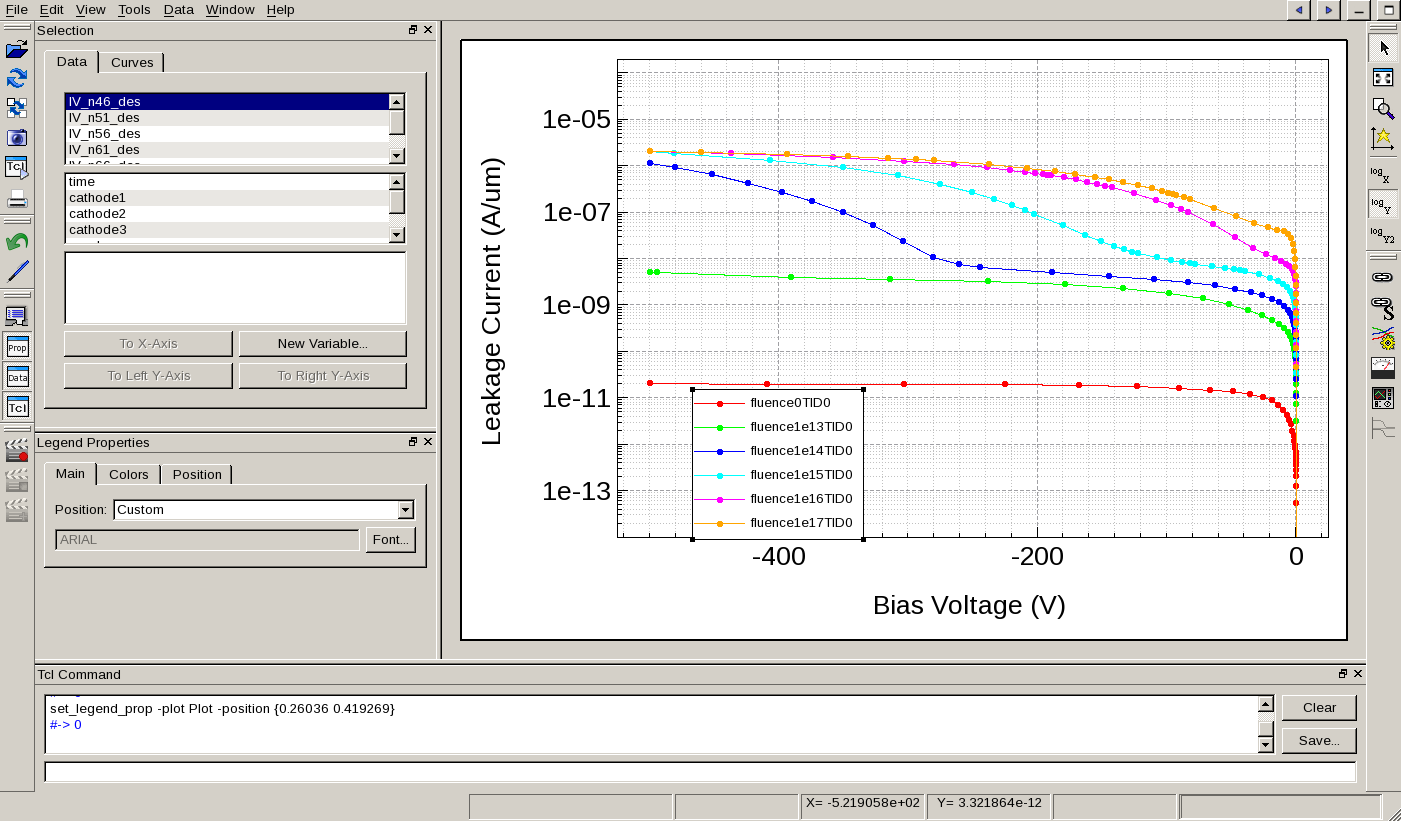 照射量に応じて案電流の増加がみられる。
照射量が高いシミュレーションでは途中からさらに増加する傾向にある。
これらの分布が実際のデバイスの測定値とどのくらい一致しているかを検証することはとても興味深いですね。
今回は温度は300Kに固定で行っていますのでその辺も変えてみたいところです。
照射量に応じて案電流の増加がみられる。
照射量が高いシミュレーションでは途中からさらに増加する傾向にある。
これらの分布が実際のデバイスの測定値とどのくらい一致しているかを検証することはとても興味深いですね。
今回は温度は300Kに固定で行っていますのでその辺も変えてみたいところです。
CV simulationNon-irrad, 1e12 , 1e13, 1e14, 1e15, 1e16, 1e17 neq/cm2の照射量でCVカーブをシミュレーション CV: n137,n142,n147, n152, n157, n162 を走らせた後プロットを見る。 | |||||||||
| Added: | |||||||||
| > > | non-irrad と1e13くらいまでは何となく問題なく測れていそうだが、それ以上は難しい...
これは実測定でも同じで、暗電流の効果で静電容量が測れないと考えられる。
 | ||||||||
MIP simulation--
| |||||||||
| Added: | |||||||||
| > > |
| ||||||||
View topic | History: r8 < r7 < r6 < r5 | More topic actions...
Ideas, requests, problems regarding TWiki? Send feedback